Fast joint EELS / EDS color map across a 32 nm transistor device
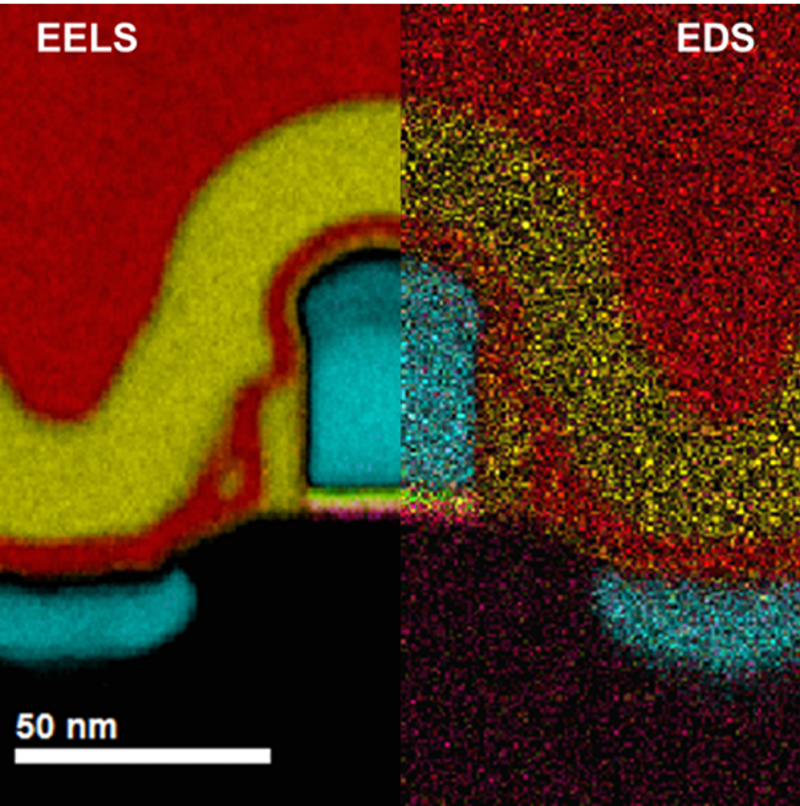
Methods probe-corrected Jeol ARM 200 TEM/STEM microscope C-FEG emission gun GIF Quantum® ER system Jeol Centurio SDD EDS detector (0.98 sr) O K at 532 eV (red); Ti L at 456 eV (green); Ni L at 855 eV (light blue); N K at 401 eV (yellow); Hf M at 1662 eV (purple) voltage: 200 kV data taken in STEM mode EELS core-loss spectrum (300 – 2300 eV): 1.5 ms
Resource category
Technique category